
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ตัวรับดาวเคราะห์ ALD
กระบวนการ ALD หมายถึงกระบวนการ Atomic Layer Epitaxy ผู้ผลิตระบบ Vetek Semiconductor และ ALD ได้พัฒนาและผลิต SiC ที่เคลือบ ALD Planetary Susceptors ซึ่งตรงตามข้อกำหนดระดับสูงของกระบวนการ ALD เพื่อกระจายการไหลเวียนของอากาศอย่างสม่ำเสมอบนซับสเตรต ในเวลาเดียวกัน การเคลือบ CVD SiC ที่มีความบริสุทธิ์สูงของ Vetek Semiconductor ช่วยให้มั่นใจได้ถึงความบริสุทธิ์ในกระบวนการ ยินดีต้อนรับสู่หารือความร่วมมือกับเรา
ส่งคำถาม
ในฐานะผู้ผลิตมืออาชีพ Vetek Semiconductor ต้องการจัดหา SiC ที่เคลือบ ALD Planetary Susceptor ให้กับคุณ
กระบวนการ ALD หรือที่เรียกว่า Atomic Layer Epitaxy ถือเป็นจุดสุดยอดของความแม่นยำในเทคโนโลยีการสะสมฟิล์มบาง Vetek Semiconductor ร่วมมือกับผู้ผลิตระบบ ALD ชั้นนำ เป็นผู้บุกเบิกการพัฒนาและการผลิตตัวรับ ALD Planetary ที่เคลือบด้วย SiC อันล้ำสมัย ตัวรับนวัตกรรมเหล่านี้ได้รับการออกแบบอย่างพิถีพิถันเพื่อให้เกินความต้องการที่เข้มงวดของกระบวนการ ALD ทำให้มั่นใจได้ว่ามีการกระจายการไหลเวียนของอากาศที่สม่ำเสมอทั่วทั้งซับสเตรตด้วยความแม่นยำและประสิทธิภาพที่ไม่มีใครเทียบได้
นอกจากนี้ ความมุ่งมั่นสู่ความเป็นเลิศของ Vetek Semiconductor แสดงให้เห็นชัดเจนโดยการใช้การเคลือบ CVD SiC ที่มีความบริสุทธิ์สูง ซึ่งรับประกันระดับความบริสุทธิ์ที่สำคัญต่อความสำเร็จของแต่ละรอบการสะสม การอุทิศตนเพื่อคุณภาพนี้ไม่เพียงแต่ช่วยเพิ่มความน่าเชื่อถือของกระบวนการ แต่ยังยกระดับประสิทธิภาพโดยรวมและความสามารถในการทำซ้ำของกระบวนการ ALD ในการใช้งานที่หลากหลาย

ข้อดีของภาพรวมเทคโนโลยี ALD:
การควบคุมความหนาที่แม่นยำ: ได้ความหนาของฟิล์มต่ำกว่านาโนเมตรพร้อมความสามารถในการทำซ้ำที่ยอดเยี่ยมโดยการควบคุมรอบการสะสม
ความเรียบของพื้นผิว: ความสอดคล้องของ 3D ที่สมบูรณ์แบบและการครอบคลุมขั้นตอน 100% ช่วยให้มั่นใจได้ว่าการเคลือบจะเรียบเนียนตามความโค้งของพื้นผิวอย่างสมบูรณ์
ใช้งานได้หลากหลาย: เคลือบได้บนวัตถุต่างๆ ตั้งแต่เวเฟอร์ไปจนถึงผง เหมาะสำหรับพื้นผิวที่ละเอียดอ่อน
คุณสมบัติของวัสดุที่ปรับแต่งได้: ปรับแต่งคุณสมบัติของวัสดุสำหรับออกไซด์ ไนไตรด์ โลหะ ฯลฯ ได้อย่างง่ายดาย
ช่วงกระบวนการกว้าง: ไม่ไวต่ออุณหภูมิหรือการเปลี่ยนแปลงของสารตั้งต้น เอื้อต่อการผลิตเป็นชุดโดยมีความสม่ำเสมอของความหนาของสีเคลือบที่สมบูรณ์แบบ
เราขอเชิญคุณเข้าร่วมการสนทนากับเราเพื่อสำรวจความร่วมมือและความร่วมมือที่เป็นไปได้ เมื่อร่วมมือกัน เราจะปลดล็อกความเป็นไปได้ใหม่ๆ และขับเคลื่อนนวัตกรรมในขอบเขตของเทคโนโลยีการสะสมของฟิล์มบาง
คุณสมบัติทางกายภาพพื้นฐานของการเคลือบ CVD SiC:
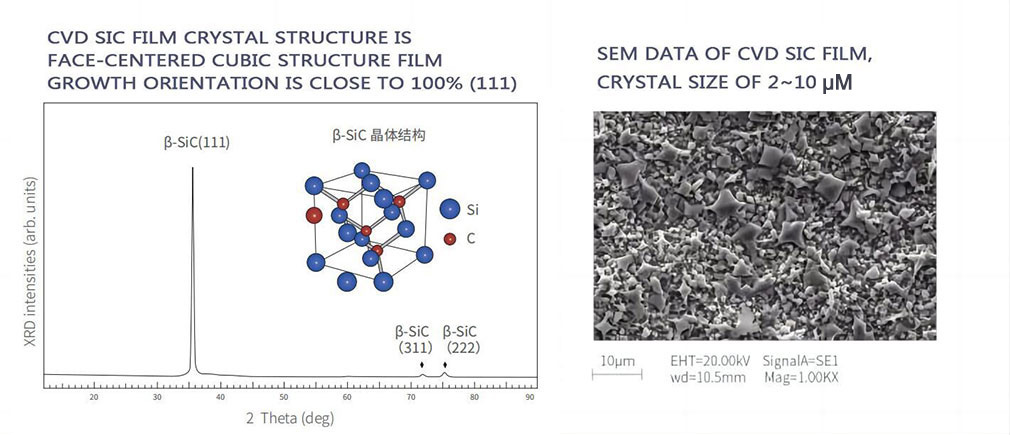
| คุณสมบัติทางกายภาพพื้นฐานของการเคลือบ CVD SiC | |
| คุณสมบัติ | ค่าทั่วไป |
| โครงสร้างคริสตัล | โพลีคริสตัลไลน์เฟส FCC β ส่วนใหญ่เน้น (111) |
| ความหนาแน่น | 3.21 ก./ซม.³ |
| ความแข็ง | ความแข็ง 2,500 วิกเกอร์ส (โหลด 500 กรัม) |
| เกรน SiZe | 2~10ไมโครเมตร |
| ความบริสุทธิ์ของสารเคมี | 99.99995% |
| ความจุความร้อน | 640 เจ·กก.-1·K-1 |
| อุณหภูมิระเหิด | 2,700 ℃ |
| ความแข็งแรงของแรงดัดงอ | 415 MPa RT 4 จุด |
| โมดูลัสของยัง | 430 Gpa 4pt โค้งงอ 1300 ℃ |
| การนำความร้อน | 300W·m-1·K-1 |
| การขยายความร้อน (CTE) | 4.5×10-6K-1 |
ร้านผลิต:

ภาพรวมของห่วงโซ่อุตสาหกรรม epitaxy ชิปเซมิคอนดักเตอร์: