
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
จีน ซิลิคอนคาร์ไบด์ Epitaxy ผู้ผลิต ผู้จำหน่าย โรงงาน
การเตรียมเอพิแทกซีซิลิคอนคาร์ไบด์คุณภาพสูงขึ้นอยู่กับเทคโนโลยีขั้นสูงและอุปกรณ์และอุปกรณ์เสริมของอุปกรณ์ ปัจจุบันวิธีการเจริญเติบโตของเยื่อบุผิวซิลิกอนคาร์ไบด์ที่ใช้กันอย่างแพร่หลายที่สุดคือการสะสมไอสารเคมี (CVD) มีข้อได้เปรียบในการควบคุมความหนาของฟิล์มเอพิแทกเซียลและความเข้มข้นของสารโด๊ปได้อย่างแม่นยำ มีข้อบกพร่องน้อยลง อัตราการเติบโตปานกลาง การควบคุมกระบวนการอัตโนมัติ ฯลฯ และเป็นเทคโนโลยีที่เชื่อถือได้ซึ่งประสบความสำเร็จในการนำไปใช้ในเชิงพาณิชย์
โดยทั่วไปแล้ว epitaxy CVD ของซิลิคอนคาร์ไบด์จะใช้อุปกรณ์ CVD ผนังร้อนหรือผนังอุ่น ซึ่งช่วยให้มั่นใจได้ถึงความต่อเนื่องของ SiC ผลึก 4H ของชั้น epitaxy ภายใต้สภาวะที่มีอุณหภูมิการเจริญเติบโตสูง (1,500 ~ 1,700 ℃), ผนังร้อนหรือ CVD ผนังอุ่นหลังจากหลายปีของการพัฒนา ตามข้อมูลของ ความสัมพันธ์ระหว่างทิศทางการไหลของอากาศเข้าและพื้นผิวของพื้นผิว ห้องปฏิกิริยาสามารถแบ่งออกเป็นเครื่องปฏิกรณ์โครงสร้างแนวนอนและเครื่องปฏิกรณ์โครงสร้างแนวตั้ง
มีตัวบ่งชี้หลักสามประการสำหรับคุณภาพของเตา epitaxial SIC ประการแรกคือประสิทธิภาพการเติบโตของ epitaxis รวมถึงความสม่ำเสมอของความหนา ความสม่ำเสมอของสารต้องห้าม อัตราข้อบกพร่อง และอัตราการเติบโต ประการที่สองคือประสิทธิภาพของอุณหภูมิของอุปกรณ์ รวมถึงอัตราการทำความร้อน/ความเย็น อุณหภูมิสูงสุด ความสม่ำเสมอของอุณหภูมิ สุดท้ายคือประสิทธิภาพด้านต้นทุนของอุปกรณ์เอง รวมถึงราคาและความจุของหน่วยเดียว
เตาการเจริญเติบโต epitaxial ของซิลิกอนคาร์ไบด์สามชนิดและความแตกต่างของอุปกรณ์เสริมหลัก
CVD แนวนอนผนังร้อน (รุ่นทั่วไป PE1O6 ของบริษัท LPE), CVD ดาวเคราะห์ผนังอุ่น (รุ่นทั่วไป Aixtron G5WWC/G10) และ CVD ผนังกึ่งร้อน (แสดงโดย EPIREVOS6 ของบริษัท Nuflare) เป็นโซลูชันทางเทคนิคของอุปกรณ์เอพิแอกเชียลกระแสหลักที่ได้รับการยอมรับ ในการใช้งานเชิงพาณิชย์ในขั้นตอนนี้ อุปกรณ์ทางเทคนิคทั้ง 3 ชิ้นยังมีลักษณะเฉพาะของตัวเองและสามารถเลือกได้ตามความต้องการ โครงสร้างของพวกเขาแสดงดังต่อไปนี้:
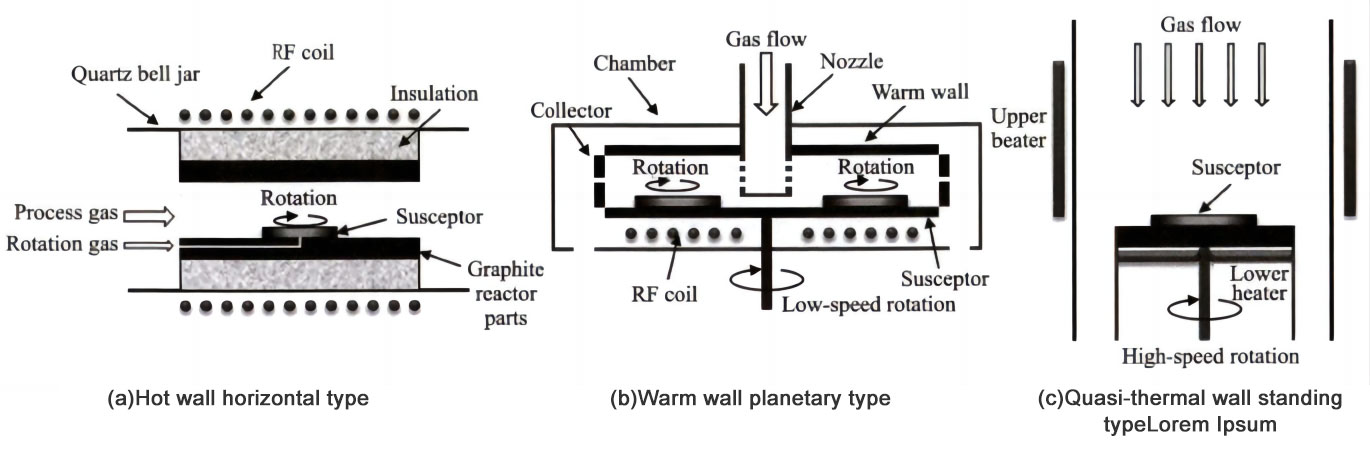
ส่วนประกอบหลักที่เกี่ยวข้องมีดังนี้:

(a) ชิ้นส่วนแกนประเภทผนังร้อนแนวนอน - ชิ้นส่วนฮาล์ฟมูนประกอบด้วย
ฉนวนปลายน้ำ
ฉนวนหลักด้านบน
ฮาล์ฟมูนตอนบน
ฉนวนต้นน้ำ
การเปลี่ยนผ่านชิ้นที่ 2
การเปลี่ยนผ่านชิ้นที่ 1
หัวฉีดอากาศภายนอก
ท่อหายใจทรงเรียว
หัวฉีดแก๊สอาร์กอนด้านนอก
หัวฉีดแก๊สอาร์กอน
แผ่นรองรับเวเฟอร์
หมุดตรงกลาง
กองกลาง
ฝาครอบป้องกันด้านท้ายน้ำด้านซ้าย
ฝาครอบป้องกันด้านท้ายน้ำด้านขวา
ฝาครอบป้องกันด้านซ้ายต้นน้ำ
ฝาครอบป้องกันต้นทางด้านขวา
ผนังด้านข้าง
แหวนกราไฟท์
รู้สึกป้องกัน
รองรับความรู้สึก
ติดต่อบล็อค
กระบอกจ่ายแก๊ส

(b) ประเภทดาวเคราะห์ผนังอุ่น
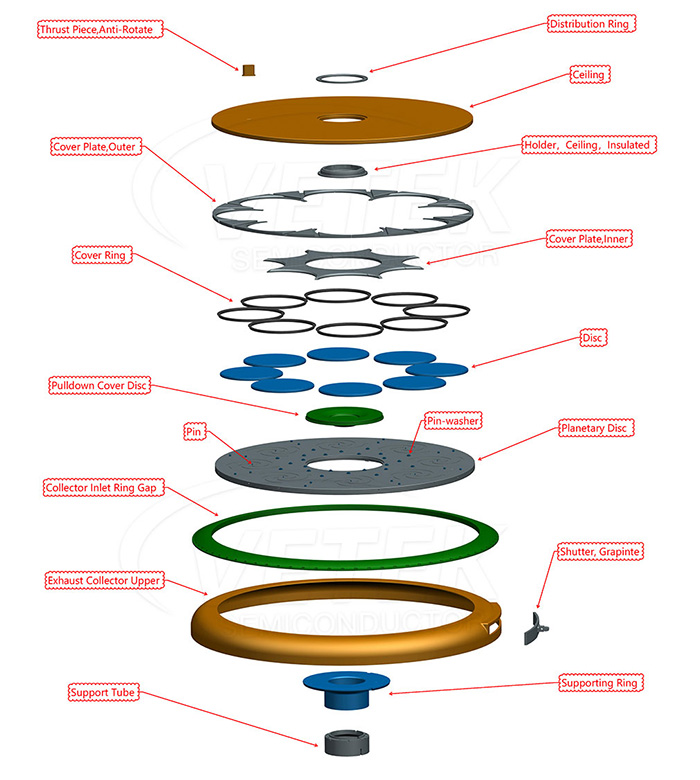

ดิสก์ดาวเคราะห์เคลือบ SiC และดิสก์ดาวเคราะห์เคลือบ TaC
(ค) ชนิดตั้งผนังกึ่งระบายความร้อน
Nuflare (ญี่ปุ่น): บริษัทนี้นำเสนอเตาเผาแนวตั้งแบบห้องคู่ที่ช่วยเพิ่มผลผลิต อุปกรณ์นี้มีการหมุนด้วยความเร็วสูงถึง 1,000 รอบต่อนาที ซึ่งมีประโยชน์อย่างมากสำหรับความสม่ำเสมอของเยื่อบุผิว นอกจากนี้ ทิศทางการไหลของอากาศยังแตกต่างจากอุปกรณ์อื่นๆ โดยอยู่ในแนวตั้งลงในแนวตั้ง จึงช่วยลดการสร้างอนุภาคและลดโอกาสที่อนุภาคจะตกลงบนแผ่นเวเฟอร์ เราจัดหาส่วนประกอบกราไฟท์เคลือบ SiC หลักสำหรับอุปกรณ์นี้

ในฐานะซัพพลายเออร์ส่วนประกอบอุปกรณ์ SiC epitaxy VeTek Semiconductor มุ่งมั่นที่จะจัดหาส่วนประกอบการเคลือบคุณภาพสูงแก่ลูกค้า เพื่อรองรับการใช้งาน SiC epitaxy ที่ประสบความสำเร็จ
- View as
แหวนทางเข้าเคลือบ SiC
Vetek Semiconductor เป็นเลิศในการร่วมมืออย่างใกล้ชิดกับลูกค้าเพื่อสร้างการออกแบบตามความต้องการสำหรับ SiC Coating Inlet Ring ที่ปรับให้เหมาะกับความต้องการเฉพาะ แหวนทางเข้าเคลือบ SiC เหล่านี้ ได้รับการออกแบบทางวิศวกรรมอย่างพิถีพิถันสำหรับการใช้งานที่หลากหลาย เช่น อุปกรณ์ CVD SiC และเอพิแทกซีซิลิคอนคาร์ไบด์ สำหรับโซลูชันแหวนทางเข้าเคลือบ SiC ที่ปรับแต่งโดยเฉพาะ โปรดติดต่อ Vetek Semiconductor เพื่อขอความช่วยเหลือเฉพาะบุคคล
อ่านเพิ่มเติมส่งคำถามแหวนความร้อนล่วงหน้า
VeTek Semiconductor เป็นผู้ริเริ่มของผู้ผลิตการเคลือบ SiC ในประเทศจีน Pre-Heat Ring จัดทำโดย VeTek Semiconductor ได้รับการออกแบบมาสำหรับกระบวนการ Epitaxy การเคลือบซิลิกอนคาร์ไบด์ที่สม่ำเสมอและวัสดุกราไฟท์คุณภาพสูงเป็นวัตถุดิบช่วยให้มั่นใจได้ถึงการสะสมที่สม่ำเสมอและปรับปรุงคุณภาพและความสม่ำเสมอของชั้น epitaxis เรากำลังรอคอยที่จะสร้างความร่วมมือระยะยาวกับคุณ
อ่านเพิ่มเติมส่งคำถามหมุดยกเวเฟอร์
VeTek Semiconductor เป็นผู้ผลิต EPI Wafer Lift Pin ชั้นนำและผู้ริเริ่มในประเทศจีน เรามีความเชี่ยวชาญในการเคลือบ SiC บนพื้นผิวของกราไฟท์มาหลายปี เราขอเสนอ EPI Wafer Lift Pin สำหรับกระบวนการ Epi ด้วยคุณภาพและราคาที่แข่งขันได้ เรายินดีต้อนรับคุณเข้าเยี่ยมชมโรงงานของเราในประเทศจีน
อ่านเพิ่มเติมส่งคำถามตัวรับ Aixtron G5 MOCVD
VeTek Semiconductor คือผู้ผลิตและผู้ริเริ่ม Aixtron G5 MOCVD Susceptors ชั้นนำในประเทศจีน เราเชี่ยวชาญด้านวัสดุเคลือบ SiC มาหลายปีแล้ว ชุด Susceptors Aixtron G5 MOCVD นี้เป็นโซลูชันอเนกประสงค์และมีประสิทธิภาพสำหรับการผลิตเซมิคอนดักเตอร์ด้วยขนาดที่เหมาะสม เข้ากันได้ และผลผลิตสูง ยินดีต้อนรับสู่สอบถามเรา
อ่านเพิ่มเติมส่งคำถามตัวรับกราไฟท์ GaN Epitaxial สำหรับ G5
VeTek Semiconductor เป็นผู้ผลิตและซัพพลายเออร์ระดับมืออาชีพที่ทุ่มเทให้กับการจัดหาตัวรับกราไฟท์ GaN Epitaxial คุณภาพสูงสำหรับ G5 เราได้สร้างความร่วมมือระยะยาวและมั่นคงกับบริษัทที่มีชื่อเสียงหลายแห่งทั้งในและต่างประเทศ โดยได้รับความไว้วางใจและความเคารพจากลูกค้าของเรา
อ่านเพิ่มเติมส่งคำถามชิ้นส่วน Halfmoon ขนาด 8 นิ้วสำหรับเครื่องปฏิกรณ์ LPE
VeTek Semiconductor คือชิ้นส่วนฮาล์ฟมูนขนาด 8 นิ้วชั้นนำสำหรับผู้ผลิตเครื่องปฏิกรณ์ LPE และผู้ริเริ่มในประเทศจีน เราเชี่ยวชาญด้านวัสดุเคลือบ SiC มาหลายปี เรานำเสนอชิ้นส่วนฮาล์ฟมูนขนาด 8 นิ้วสำหรับเครื่องปฏิกรณ์ LPE ที่ออกแบบมาโดยเฉพาะสำหรับเครื่องปฏิกรณ์ epitaxy LPE SiC Halfmoon นี้เป็นโซลูชันอเนกประสงค์และมีประสิทธิภาพสำหรับการผลิตเซมิคอนดักเตอร์ด้วยขนาดที่เหมาะสม ความเข้ากันได้ และความสามารถในการผลิตสูง เรายินดีต้อนรับคุณเข้าเยี่ยมชมโรงงานของเราในประเทศจีน
อ่านเพิ่มเติมส่งคำถาม












